
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
반도체 산업의 건식 식각 기술 이해
에칭은 설계된 구조 패턴을 얻기 위해 물리적 또는 화학적 수단을 통해 재료를 선택적으로 제거하는 기술을 의미합니다.
현재 많은 반도체 장치는 주로 두 가지 유형의 에칭을 통해 생성되는 메사 장치 구조를 사용합니다.습식 에칭과 건식 에칭. 간단하고 빠른 습식 식각은 반도체 소자 제조에 중요한 역할을 하지만 등방성 식각과 균일성이 좋지 않은 등의 고유한 단점이 있어 작은 크기의 패턴을 전사할 때 제어가 제한됩니다. 그러나 높은 이방성, 우수한 균일성 및 반복성을 갖춘 건식 에칭이 반도체 장치 제조 공정에서 두드러지게 나타났습니다. '건식 식각'이라는 용어는 레이저 식각, 플라즈마 식각, 화학 기상 식각 등 표면 물질을 제거하고 마이크로 및 나노 패턴을 전사하는 데 사용되는 모든 비습식 식각 기술을 광범위하게 지칭합니다. 이 문서에서 논의된 건식 에칭은 특히 재료 표면을 수정하기 위해 플라즈마 방전(물리적 또는 화학적)을 사용하는 프로세스의 좁은 적용과 관련이 있습니다. 다음을 포함하여 몇 가지 일반적인 산업용 에칭 기술을 다룹니다.IBE(이온빔 에칭), RIE(반응성 이온 에칭), ECR(전자 사이클로트론 공명) 플라즈마 에칭 및 ICP(유도 결합 플라즈마) 에칭.
1. 이온빔 에칭(IBE)
이온 밀링이라고도 알려진 IBE는 1970년대에 순수한 물리적 에칭 방법으로 개발되었습니다. 이 프로세스에는 타겟 물질의 표면을 폭격하기 위해 전압에 의해 가속되는 불활성 가스(Ar, Xe 등)에서 생성된 이온 빔이 포함됩니다. 이온은 에너지를 표면 원자로 전달하여 결합 에너지를 초과하는 에너지를 가진 이온이 스퍼터링되도록 합니다. 이 기술은 가속 전압을 사용하여 이온빔의 방향과 에너지를 제어하므로 식각 이방성과 속도 제어성이 뛰어납니다. 세라믹 및 특정 금속과 같이 화학적으로 안정한 재료를 에칭하는 데 이상적이지만 더 깊은 에칭을 위해 더 두꺼운 마스크가 필요하므로 에칭 정밀도가 저하될 수 있으며 고에너지 이온 충격으로 인해 격자 붕괴로 인해 피할 수 없는 전기적 손상이 발생할 수 있습니다.

2. 반응성 이온 에칭(RIE)
IBE에서 개발된 RIE는 화학 반응과 물리적 이온 충격을 결합합니다. IBE에 비해 RIE는 넓은 영역에 걸쳐 더 높은 에칭 속도와 우수한 이방성 및 균일성을 제공하므로 마이크로 및 나노 제조에서 가장 광범위하게 사용되는 에칭 기술 중 하나입니다. 이 프로세스에는 평행판 전극에 무선 주파수(RF) 전압을 적용하여 챔버의 전자가 반응 가스를 가속 및 이온화시켜 플레이트의 한쪽 면에서 안정적인 플라즈마 상태를 만드는 과정이 포함됩니다. 플라즈마는 전자가 음극에 끌리고 양극에 접지되어 챔버 전체에 전기장을 생성하기 때문에 양의 전위를 전달합니다. 양으로 대전된 플라즈마는 음극으로 연결된 기판을 향해 가속되어 효과적으로 에칭됩니다.
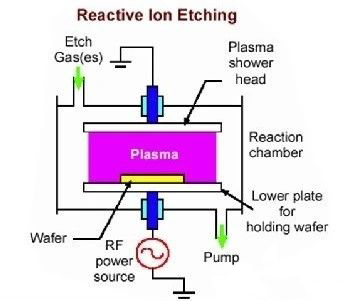
식각 공정 동안 챔버는 저압 환경(0.1~10 Pa)을 유지하여 반응 가스의 이온화 속도를 높이고 기판 표면의 화학 반응 과정을 가속화합니다. 일반적으로 RIE 공정에서는 휘발되는 반응 부산물을 진공 시스템에 의해 효율적으로 제거해야 하므로 높은 식각 정밀도가 보장됩니다. RF 전력 레벨은 플라즈마 밀도와 가속 바이어스 전압을 직접 결정하여 에칭 속도를 제어합니다. 그러나 RIE는 플라즈마 밀도를 높이는 동시에 바이어스 전압도 증가시켜 격자 손상을 일으키고 마스크의 선택성을 감소시켜 에칭 애플리케이션에 제한을 가할 수 있습니다. 대규모 집적회로의 급속한 발전과 트랜지스터의 크기 감소로 인해 마이크로 및 나노 가공에서 정밀도와 종횡비에 대한 요구가 높아지면서 고밀도 플라즈마 기반 건식 식각 기술이 등장하게 되었습니다. 전자 정보 기술 발전을 위한 새로운 기회.
3. 전자 사이클로트론 공명(ECR) 플라즈마 에칭
고밀도 플라즈마를 달성하기 위한 초기 방법인 ECR 기술은 마이크로파 에너지를 활용하여 챔버 내 전자와 공명하고, 외부에서 인가된 주파수 일치 자기장으로 강화되어 전자 사이클로트론 공명을 유도합니다. 이 방법은 RIE보다 훨씬 더 높은 플라즈마 밀도를 달성하여 식각 속도와 마스크 선택성을 향상시켜 초고종횡비 구조의 식각을 용이하게 합니다. 그러나 마이크로파 소스, RF 소스 및 자기장의 조화로운 기능에 의존하는 시스템의 복잡성으로 인해 운영상의 문제가 발생합니다. ICP(유도 결합 플라즈마) 에칭의 출현은 곧 ECR에 대한 단순화로 이어졌습니다.
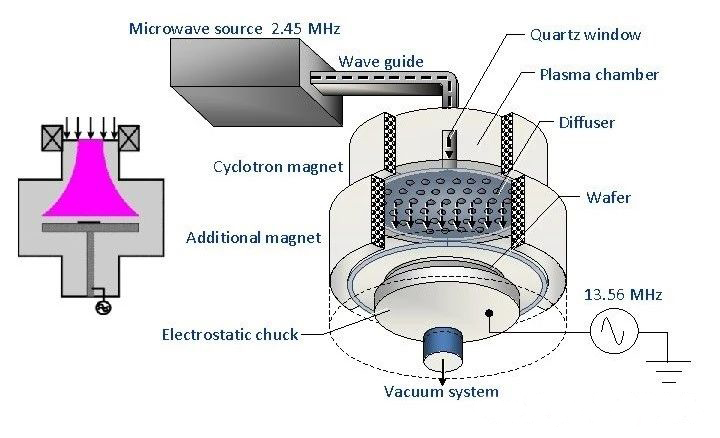
4. 유도 결합 플라즈마(ICP) 에칭
ICP 에칭 기술은 두 개의 13.56MHz RF 소스를 사용하여 플라즈마 생성과 가속 바이어스 전압을 모두 제어함으로써 ECR 기술을 기반으로 시스템을 단순화합니다. ECR에 사용되는 외부 자기장 대신 나선형 코일은 회로도에 표시된 것처럼 교번 전자기장을 유도합니다. RF 소스는 전자기 결합을 통해 내부 전자에 에너지를 전달합니다. 내부 전자는 유도 장 내에서 사이클로트론 운동으로 움직이며 반응 가스와 충돌하여 이온화를 일으킵니다. 이 설정은 ECR과 비슷한 플라즈마 밀도를 달성합니다. ICP 에칭은 다양한 에칭 시스템의 장점을 결합하여 높은 에칭 속도, 높은 선택성, 대면적 균일성 및 단순하고 제어 가능한 장비 구조에 대한 요구를 충족하므로 차세대 고밀도 플라즈마 에칭 기술에서 빠르게 선호되는 선택이 되고 있습니다. .
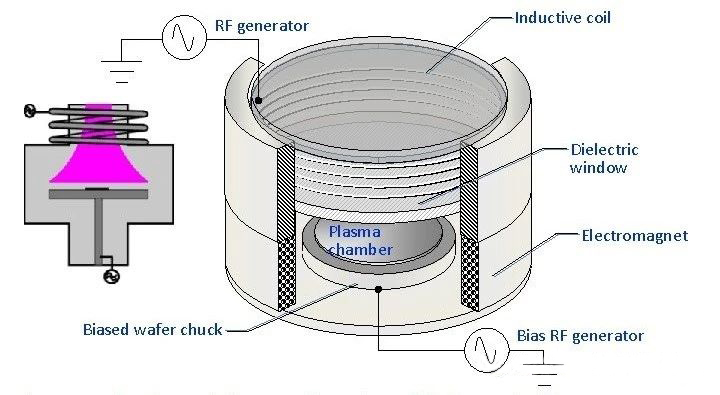
5. 드라이에칭의 특징
건식 식각 기술은 우수한 이방성과 높은 식각 속도로 인해 습식 식각을 대체하면서 마이크로 및 나노 가공 분야에서 빠르게 주요 위치를 차지했습니다. 우수한 건식 식각 기술을 평가하는 기준에는 마스크 선택성, 이방성, 식각 속도, 전체 균일성, 격자 손상으로 인한 표면 평활도 등이 포함됩니다. 다양한 평가 기준이 있으므로 제조 요구 사항에 따라 특정 상황을 고려해야 합니다. 건식 에칭의 가장 직접적인 지표는 에칭된 바닥과 측벽의 평탄도, 에칭된 테라스의 이방성을 포함한 표면 형태이며, 둘 다 물리적 충격에 대한 화학적 반응의 비율을 조정하여 제어할 수 있습니다. 에칭 후 현미경 특성 분석은 일반적으로 주사 전자 현미경 및 원자력 현미경을 사용하여 수행됩니다. 동일한 에칭 조건 및 시간에서 재료의 에칭 깊이에 대한 마스크 에칭 깊이의 비율인 마스크 선택성이 중요합니다. 일반적으로 선택성이 높을수록 패턴 전사의 정확도가 높아집니다. ICP 에칭에 사용되는 일반적인 마스크에는 포토레지스트, 금속 및 유전체 필름이 포함됩니다. 포토레지스트는 선택성이 낮고 고온이나 강력한 충격으로 성능이 저하될 수 있습니다. 금속은 높은 선택성을 제공하지만 마스크 제거에 어려움을 겪고 종종 다층 마스킹 기술이 필요합니다. 또한, 금속 마스크는 에칭 중에 측벽에 부착되어 누출 경로를 형성할 수 있습니다. 따라서 적절한 마스크 기술을 선택하는 것은 식각에 특히 중요하며 마스크 재료의 선택은 장치의 특정 성능 요구 사항에 따라 결정되어야 합니다.**




