
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
칩 제조 분야의 SiGe: 전문 뉴스 보고서
반도체 소재의 진화
현대 반도체 기술 영역에서 소형화를 향한 끊임없는 노력은 기존 실리콘 기반 소재의 한계를 뛰어넘었습니다. 고성능 및 저전력 소비에 대한 요구를 충족시키기 위해 SiGe(실리콘 게르마늄)는 고유한 물리적, 전기적 특성으로 인해 반도체 칩 제조에서 선택되는 복합 재료로 부상했습니다. 이 기사에서는에피택시 공정SiGe의 에피택셜 성장, 스트레인드 실리콘 애플리케이션 및 GAA(Gate-All-Around) 구조에서의 역할.
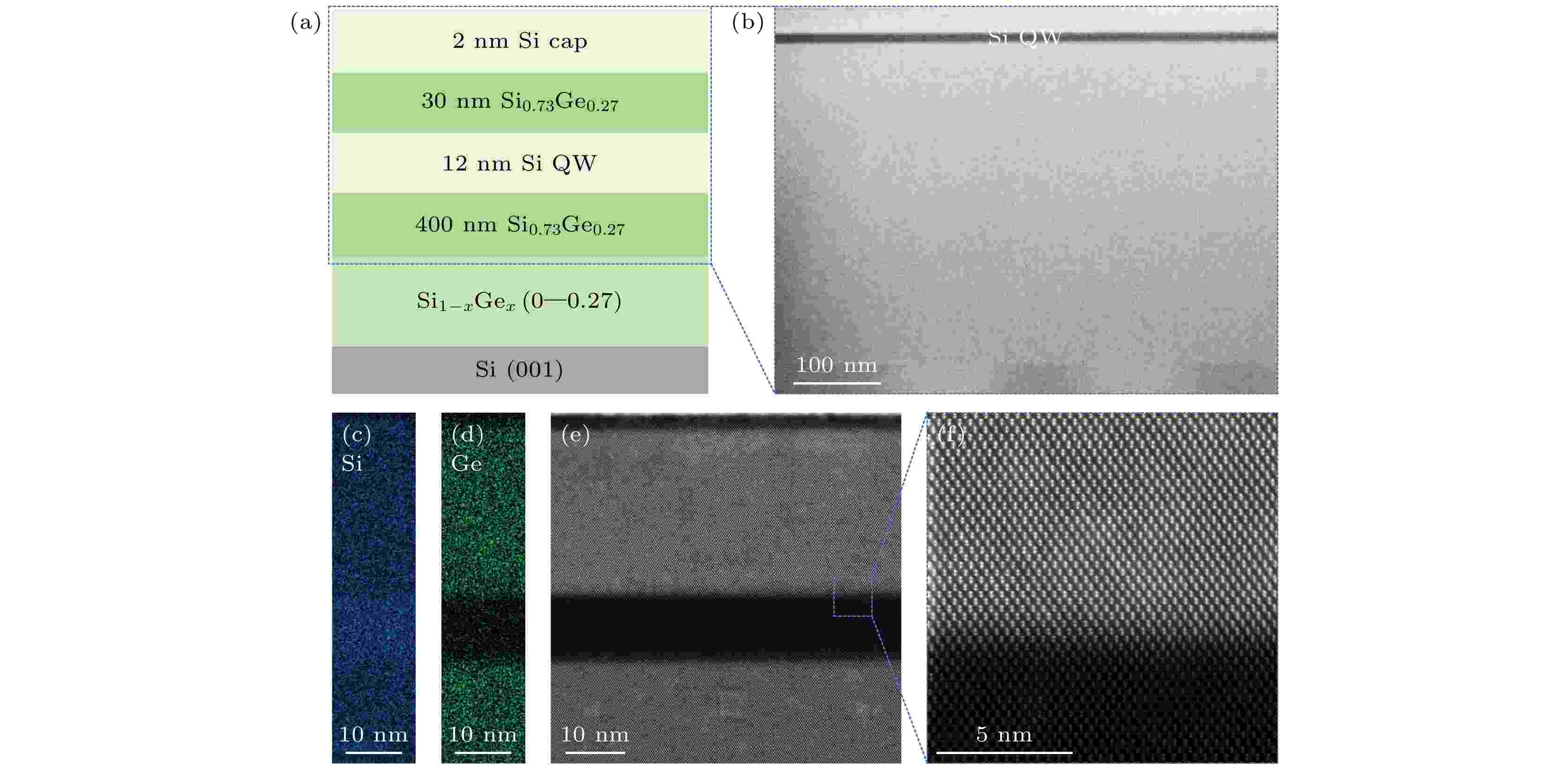
SiGe 에피택시의 중요성
1.1 칩 제조에서의 에피택시 소개:
흔히 Epi로 약칭되는 에피택시(Epitaxy)는 동일한 격자 배열을 가진 단결정 기판 위에 단결정 층이 성장하는 것을 의미합니다. 이 레이어는 다음 중 하나일 수 있습니다.동종에피택셜(예: Si/Si)또는 헤테로에피택셜(예: SiGe/Si 또는 SiC/Si). 에피택셜 성장에는 MBE(분자빔 에피택시), UHV/CVD(초고진공 화학 기상 증착), ATM 및 RP Epi(대기 및 감압 에피택시)를 비롯한 다양한 방법이 사용됩니다. 이 기사에서는 실리콘을 기판 재료로 사용하는 반도체 집적 회로 생산에 널리 사용되는 실리콘(Si) 및 실리콘-게르마늄(SiGe)의 에피택시 공정에 중점을 둡니다.
1.2 SiGe 에피택시의 장점:
일정 비율의 게르마늄(Ge)을 첨가하는 동안에피택시 공정밴드갭 폭을 줄일 뿐만 아니라 트랜지스터의 차단 주파수(fT)를 높이는 SiGe 단결정층을 형성합니다. 따라서 무선 및 광통신용 고주파 장치에 광범위하게 적용할 수 있습니다. 또한 고급 CMOS 집적 회로 공정에서는 Ge와 Si 사이의 격자 불일치(약 4%)로 인해 격자 응력이 발생하여 전자나 정공의 이동성이 향상되어 장치의 포화 전류와 응답 속도가 증가합니다.
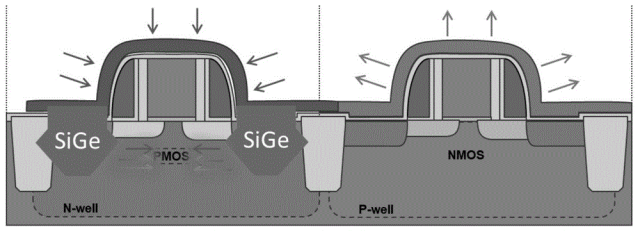
포괄적인 SiGe 에피택시 공정 흐름
2.1 전처리:
실리콘 웨이퍼는 원하는 공정 결과에 따라 전처리되며, 주로 웨이퍼 표면의 자연 산화물 층과 불순물을 제거하는 작업이 포함됩니다. 고농도로 도핑된 기판 웨이퍼의 경우 후속 공정에서 자동 도핑을 줄이기 위해 백실링이 필요한지 여부를 고려하는 것이 중요합니다.에피택시 성장.
2.2 성장 가스 및 조건:
실리콘 가스: 실란(SiH₄), 디클로로실란(DCS, SiH2Cl2) 및 트리클로로실란(TCS, SiHCl₃)은 가장 일반적으로 사용되는 세 가지 실리콘 가스 소스입니다. SiH₄는 저온 완전 에피택시 공정에 적합한 반면, 성장 속도가 빠른 TCS는 두꺼운 반도체 공정에 널리 사용된다.실리콘 에피택시레이어.
게르마늄 가스: 게르마늄(GeH₄)은 게르마늄을 첨가하는 주요 소스이며 SiGe 합금을 형성하기 위해 실리콘 소스와 함께 사용됩니다.
선택적 에피택시(Selective Epitaxy): 선택적 성장은 상대적 비율을 조정하여 달성됩니다.에피택셜 증착염소 함유 실리콘 가스 DCS를 사용한 현장 에칭. 선택성은 실리콘 표면의 Cl 원자 흡착이 산화물이나 질화물의 흡착보다 적기 때문에 에피택시 성장을 촉진합니다. Cl 원자가 부족하고 활성화 에너지가 낮은 SiH₄는 일반적으로 저온 완전 에피택시 공정에만 적용됩니다. 일반적으로 사용되는 또 다른 실리콘 소스인 TCS는 증기압이 낮고 실온에서 액체이므로 반응 챔버에 도입하려면 H2 버블링이 필요합니다. 그러나 실리콘 에피택시 웨이퍼 생산에 널리 적용되는 더 두꺼운 실리콘 에피택시 층을 성장시키기 위해 상대적으로 저렴하고 빠른 성장 속도(최대 5μm/분)로 자주 사용됩니다.
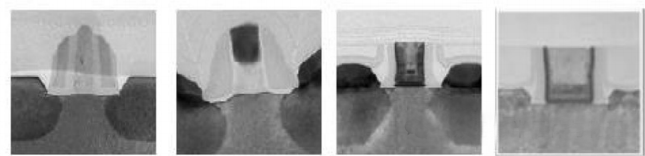
에피택셜 층의 변형된 실리콘
동안에피택셜 성장에피택셜 단결정 Si는 완화된 SiGe 층에 증착됩니다. Si와 SiGe 사이의 격자 불일치로 인해 Si 단결정 층은 기본 SiGe 층으로부터 인장 응력을 받게 되어 NMOS 트랜지스터의 전자 이동도가 크게 향상됩니다. 이 기술은 포화 전류(Idsat)를 높이는 동시에 기기 응답 속도도 향상시킨다. PMOS 장치의 경우 SiGe 층은 에칭 후 소스 및 드레인 영역에서 에피택셜 성장되어 채널에 압축 응력을 도입하여 정공 이동성을 향상시키고 포화 전류를 증가시킵니다.
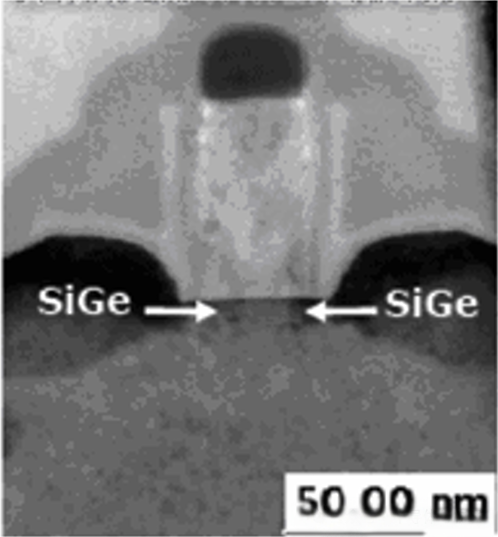
GAA 구조의 희생층으로서의 SiGe
GAA(Gate-All-Around) 나노와이어 트랜지스터 제조에서 SiGe 층은 희생층 역할을 합니다. 준원자층 에칭(quasi-ALE)과 같은 고선택성 이방성 에칭 기술을 사용하면 SiGe 층을 정밀하게 제거하여 나노와이어 또는 나노시트 구조를 형성할 수 있습니다.

Semicorex는 다음을 전문으로 합니다.SiC/TaC 코팅 흑연 솔루션반도체 제조 분야의 Si 에피택셜 성장에 적용됩니다. 문의 사항이 있거나 추가 세부 정보가 필요한 경우 주저하지 말고 당사에 문의하십시오.
전화번호: +86-13567891907
이메일: sales@semicorex.com




