
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
주류 분리 방법
반도체 공정의 발달과 전자부품 수요의 증가로 초박형 웨이퍼(두께 100마이크로미터 이하)의 적용이 점점 더 중요해지고 있습니다. 그러나 웨이퍼 두께가 지속적으로 감소함에 따라 웨이퍼는 연삭, 에칭, 금속화와 같은 후속 공정에서 파손될 위험이 매우 높습니다.
임시 본딩 및 디본딩 기술은 일반적으로 반도체 소자의 안정적인 성능과 생산 수율을 보장하기 위해 적용됩니다. 초박형 웨이퍼는 견고한 캐리어 기판에 임시로 고정되고, 후면 처리 후 두 개는 분리됩니다. 이 분리 공정은 주로 열적 분리, 레이저 분리, 화학적 분리 및 기계적 분리를 포함하는 분리로 알려져 있습니다.
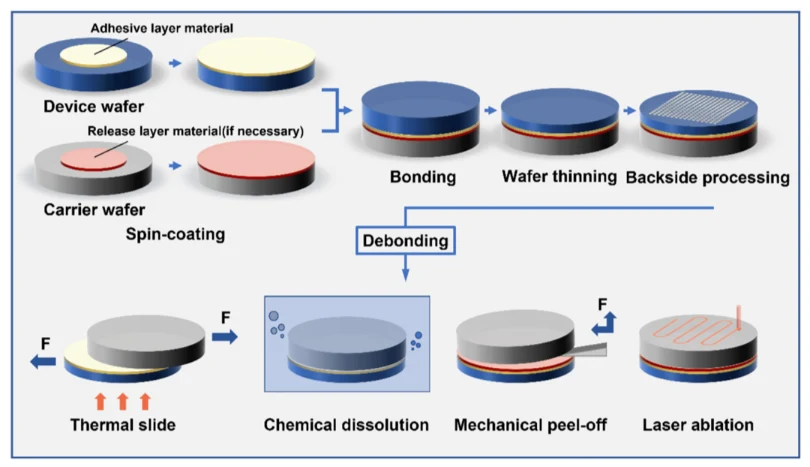
열적 분리
열탈착(Thermal Debonding)은 초박형 웨이퍼를 캐리어 기판에서 가열해 분리해 접착 접착제를 연화·분해시켜 접착력을 잃는 방식이다. 주로 열 슬라이드 탈착과 열분해 탈착으로 구분됩니다.
열 슬라이드 분리에는 일반적으로 접착된 웨이퍼를 연화 온도(약 190°C ~ 220°C)까지 가열하는 작업이 포함됩니다. 이 온도에서는 접착 접착제의 접착력이 떨어지고 초박형 웨이퍼는 다음과 같은 장치에 의해 가해지는 전단력에 의해 캐리어 기판에서 천천히 밀리거나 벗겨질 수 있습니다.진공 척원활한 분리를 실현합니다. 열분해 분리 과정에서 접착된 웨이퍼는 더 높은 온도로 가열되어 접착제의 화학적 분해(분자 사슬 절단)를 일으키고 접착력을 완전히 잃습니다. 그 결과, 접착된 웨이퍼는 기계적인 힘을 가하지 않고도 자연스럽게 분리될 수 있습니다.
레이저 디본딩
레이저 디본딩은 접합된 웨이퍼의 접착층에 레이저 조사를 활용하는 디본딩 방법입니다. 접착층은 레이저 에너지를 흡수하여 열을 발생시켜 광분해 반응을 일으킵니다. 이러한 접근 방식을 통해 실온 또는 상대적으로 낮은 온도에서 캐리어 기판으로부터 초박형 웨이퍼를 분리할 수 있습니다.
그러나 레이저 디본딩을 위한 중요한 전제 조건은 캐리어 기판이 사용되는 레이저 파장에 대해 투명해야 한다는 것입니다. 이러한 방식으로 레이저 에너지는 캐리어 기판을 성공적으로 관통하고 결합층 재료에 효과적으로 흡수될 수 있습니다. 이러한 이유로 레이저 파장의 선택이 중요합니다. 일반적인 파장에는 248 nm 및 365 nm가 포함되며 이는 결합 재료의 광 흡수 특성과 일치해야 합니다.
화학적 분리
화학적 디본딩은 전용 화학 용매로 접착층을 용해시켜 접착된 웨이퍼를 분리합니다. 이 공정에서는 접착층을 관통하는 용매 분자가 팽창, 사슬 절단 및 최종 용해를 유발해야 하며, 이로 인해 초박형 웨이퍼와 캐리어 기판이 자연적으로 분리될 수 있습니다. 따라서 추가 가열 장비나 진공 척에 의해 제공되는 기계적 힘이 필요하지 않으며, 화학적 분리는 웨이퍼에 최소한의 응력을 발생시킵니다.
이 방법에서는 용매가 결합층에 완전히 접촉하여 용해될 수 있도록 캐리어 웨이퍼를 사전 드릴링하는 경우가 많습니다. 접착제 두께는 용매 침투 및 용해의 효율성과 균일성에 영향을 미칩니다. 수용성 접착 접착제는 대부분 열가소성 또는 변형된 폴리이미드 기반 재료이며 일반적으로 스핀 코팅으로 적용됩니다.
기계적 분리
기계적 디본딩은 열, 화학적 용매 또는 레이저 없이 제어된 기계적 박리력을 적용함으로써 임시 캐리어 기판에서 초박형 웨이퍼를 분리합니다. 이 과정은 정밀한 기계적 작동을 통해 웨이퍼가 부드럽게 "들어 올려지는" 테이프를 떼어내는 것과 유사합니다.
Semicorex는 고품질을 제공합니다.SIC 다공성 세라믹 디본딩 척. 문의사항이 있거나 추가 세부정보가 필요한 경우, 주저하지 마시고 연락주시기 바랍니다.
전화번호 +86-13567891907에 문의하세요.
이메일: sales@semicorex.com




